삼성전자, 업계 최초 36GB HBM3E 12H D램 개발
승인
2024-02-27 18:16
박수철 기자
scp@kyeonggi.com
기자페이지
김도균 기자
dok5@kyeonggi.com
기자페이지
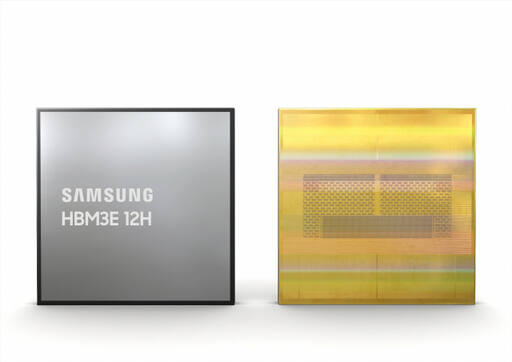
삼성전자가 업계 최초 36GB HBM3E 12H D램 개발에 성공했다.
삼성전자는 실리콘 관통 전극(TSV) 기술을 통해 24Gb D램 칩을 12단까지 적층해 36GB HBM3E 12H를 구현했다.
TSV는 수천 개 미세구멍을 뚫은 D램 칩을 수직으로 쌓아 침 사이를 전극으로 연결하는 기술이다.
HBM3E 12H는 전작인 HBM3 8H 대비 50% 이상 개선된 제품으로, 초당 최대 1,280GB의 대역폭과 36GB 용량을 제공한다.
삼성전자는 ‘Advanced TC NCF(열압착 비전도성 접착 필름)’ 기술로 12H를 8H와 동일한 높이로 구현해 HBM 패키지 규격을 충족시켰다.
해당 기술은 적층수 증가 및 칩 두께가 얇아짐에 따라 발생할 수 있는 휘어짐 현상을 최소화할 수 있어 고단 적층 확장에 용이하다.
삼성전자는 신제품이 AI 서비스 고도화로 데이터 처리량이 급증한 AI 업계뿐만 아니라 기업의 리소스 관리에 유연성을 제공할 것으로 기대하고 있다.
삼성전자는 고객사에 샘플을 제공하는 한편 상반기 내 양산에 돌입할 계획이다.
배용철 삼성전자 메모리사업부 상품기획실장(부사장)은 “삼성전자는 AI 서비스를 제공하는 고객사의 고용량 설루션 니즈에 부합하는 혁신 제품 개발에 힘쓰고 있다”며 “앞으로 HBM 고단 적층을 위한 기술 개발에 주력하는 등 고용량 HBM 시장을 선도하고 개척해 나가겠다”고 말했다.
© 경기일보(www.kyeonggi.com), 무단전재 및 수집, 재배포금지


로그인 후 이용해 주세요